服務熱線
17701039158

技術(shù)文章
TECHNICAL ARTICLES 更新時間:2025-08-14
更新時間:2025-08-14 點擊次數(shù):80
點擊次數(shù):80
一、鄰近效應:微納加工的“隱形殺手
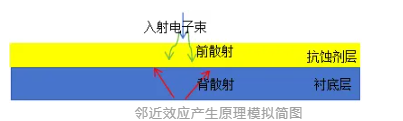
當電子束穿透光刻膠時,會與材料發(fā)生復雜相互作用:一部分電子前向散射,另一部分被襯底反彈形成背散射電子。這些“不聽話"的電子會擴散到預設圖形區(qū)域之外,就像墨水在宣紙上暈染開一般,造成中心區(qū)域欠曝、邊緣過曝的現(xiàn)象。從澤攸科技的實驗數(shù)據(jù)可見(圖2)未校正時,同一芯片上不同區(qū)域的線寬差異可達30%以上。
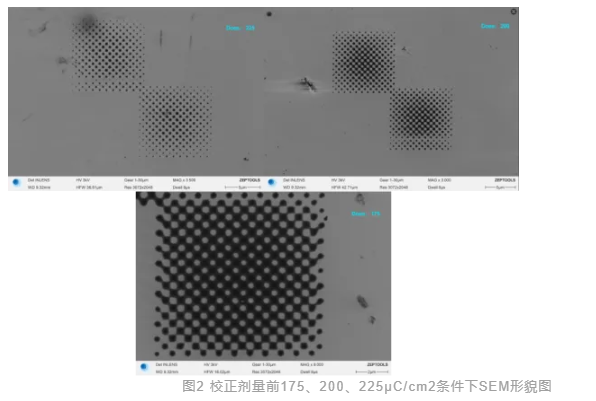
二、劑量校正技術(shù):給電子束裝上“導航系統(tǒng)"
傳統(tǒng)解決方式如同“盲人摸象",而澤攸科技采用的智能劑量校正方案實現(xiàn)了三大創(chuàng)新:
1.雙高斯建模:通過α(前散射)、β(背散射)、η(比例系數(shù))三個核心參數(shù),精準模擬電子能量沉積分布
2.動態(tài)補償算法:如圖3所示,系統(tǒng)能自動識別欠曝區(qū)域(補償系數(shù)>1.25)和過曝區(qū)域(系數(shù)<1.15),實現(xiàn)像素級劑量調(diào)節(jié)
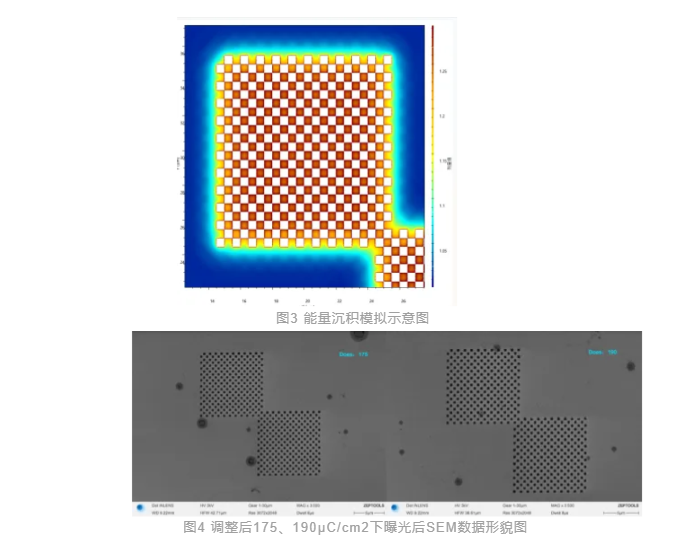
3.材料數(shù)據(jù)庫支持:集成PMMA、HSQ等常見光刻膠及硅、石英等襯底材料的散射參數(shù),使校正效率提升60%
三、實測表現(xiàn):棋盤圖形見證精度飛躍

在100nm厚PMMA膠、30kV加速電壓的測試中,優(yōu)化后的150μC/cm2劑量組展現(xiàn)出突破性效果(圖5):
中心區(qū)域圖形均勻性提升80%
邊緣孤立圖形尺寸偏差從±25%縮小至±8%
整體分辨率達到設計線寬500nm的±3%誤差范圍內(nèi)
四、技術(shù)展望:讓中國智造更“精密"
盡管當前技術(shù)對復雜圖形的適應性仍有提升空間,但澤攸科技已將該算法集成至自主開發(fā)的HNU-EBL軟件中。未來結(jié)合AI預測模型和實時電子束調(diào)控,有望將校正精度推進至亞納米級。正如團隊負責人所言:“解決鄰近效應,就是打開量子器件、光子芯片產(chǎn)業(yè)化大門的鑰匙。"
澤攸 EBL 電子光刻,作為前沿的微納加工技術(shù),無需掩模即可實現(xiàn)納米級圖案直寫。其工作原理是借助聚焦電子束,精準作用于電子敏感光刻膠表面。澤攸科技憑借自主研發(fā)實力,構(gòu)建起完備的技術(shù)體系。旗下 ZEL304G 機型亮點突出,配備高亮度、低發(fā)散的肖特基場發(fā)射電子槍,確保電子束精準 “繪制" 納米線條;標配的激光干涉樣品臺,定位精度達亞納米級,支持大行程高精度拼接與多圖層套刻;高性能圖形發(fā)生器采用 20 位 D/A 轉(zhuǎn)換器與 50MHz 高速掃描模塊,實現(xiàn)超高速掃描與≤1nm@15kV 的超高圖像分辨率,最小單次曝光線寬僅 2nm。此外,還內(nèi)置鄰近效應校正功能,有效提升納米圖案均勻性。在科研與工業(yè)領(lǐng)域,澤攸 EBL 電子光刻助力二維材料器件制備,為微機電系統(tǒng)、光刻掩膜制造等提供高精度加工方案 ,推動行業(yè)創(chuàng)新發(fā)展。
 公司地址:北京市房山區(qū)長陽鎮(zhèn)
公司地址:北京市房山區(qū)長陽鎮(zhèn) 公司郵箱:qiufangying@bjygtech.com
公司郵箱:qiufangying@bjygtech.com掃碼加微信

Copyright©2025 北京儀光科技有限公司 版權(quán)所有 備案號:京ICP備2021017793號-2 sitemap.xml
技術(shù)支持:化工儀器網(wǎng) 管理登陸